微流控与金属片电极的镶嵌工艺技术:微流控与金属片电极的镶嵌工艺实现了流体通道与固态电极的无缝集成,适用于电化学检测、电渗流驱动等场景。加工过程中,首先在硅片或玻璃基板上制备微流道(深度50-200μm,宽度100-500μm),然后将预加工的金属片电极(如不锈钢、金箔)嵌入流道侧壁,通过导电胶(银胶或碳胶)固定,确保电极与流道内壁齐平,间隙<5μm。键合采用热压或紫外固化胶密封,耐压>100kPa,漏电流<1nA。金属片电极的表面积可根据需求设计,如5mm×5mm的金电极,电化学活性面积达20mm²,适用于痕量物质检测。在水质监测芯片中,镶嵌的铂电极可实时检测溶解氧浓度,响应时间<10秒,检测范围0-20ppm,精度±0.5ppm。该工艺解决了传统微流控芯片与外置电极连接的接触电阻问题,实现了芯片内原位检测,缩短信号传输路径,提升检测速度与稳定性。公司开发的自动化镶嵌设备,定位精度±10μm,单芯片加工时间<5分钟,支持批量生产,为环境监测、食品安全检测等领域提供了集成化的传感解决方案。以PI为特色的柔性电子在太赫兹超表面器件上的应用很广。个性化MEMS微纳米加工联系人
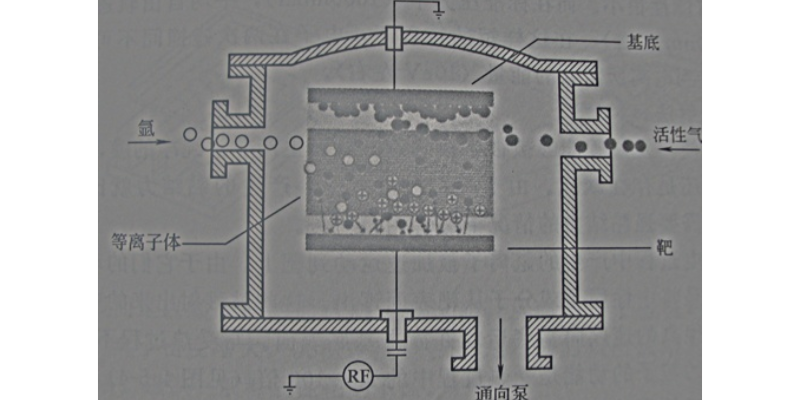
MEMS制作工艺-太赫兹超导混频阵列的MEMS体硅集成天线与封装技术:
太赫兹波是天文探测领域的重要波段,太赫兹波探测对提升人类认知宇宙的能力有重要意义。太赫兹超导混频接收机是具有代表性的高灵敏天文探测设备。天线及混频芯片封装是太赫兹接收前端系统的关键组件。当前,太赫兹超导接收机多采用单独的金属喇叭天线和金属封装,很难进行高集成度阵列扩展。大规模太赫兹阵列接收机发展很大程度受到天线及芯片封装技术的制约。课题拟研究基于MEMS体硅工艺技术的适合大规模太赫兹超导接收阵列应用的0.4THz以上频段高性能集成波纹喇叭天线,及该天线与超导混频芯片一体化封装。通过电磁场理论分析、电磁场数值建模与仿真、低温超导实验验证等手段, 新型MEMS微纳米加工发展现状超声芯片封装采用三维堆叠技术,缩小尺寸 40% 并提升信噪比至 73.5dB,优化成像质量。
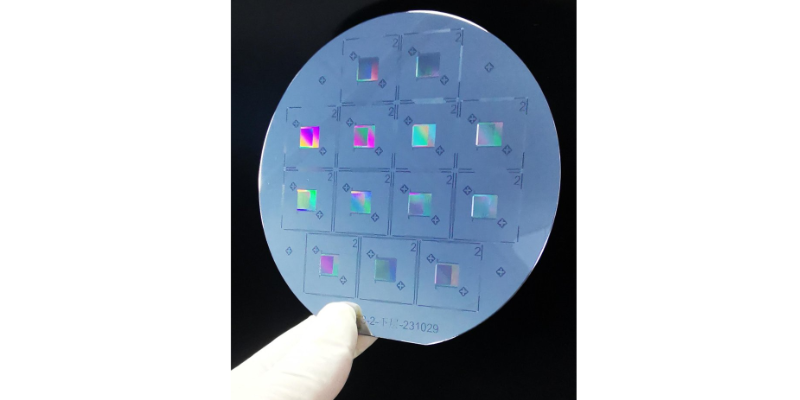
MEMS技术的主要分类:传感MEMS技术是指用微电子微机械加工出来的、用敏感元件如电容、压电、压阻、热电耦、谐振、隧道电流等来感受转换电信号的器件和系统。它包括速度、压力、湿度、加速度、气体、磁、光、声、生物、化学等各种传感器,按种类分主要有:面阵触觉传感器、谐振力敏感传感器、微型加速度传感器、真空微电子传感器等。传感器的发展方向是阵列化、集成化、智能化。由于传感器是人类探索自然界的触角,是各种自动化装置的神经元,且应用领域大,未来将备受世界各国的重视。
MEMS制作工艺柔性电子的定义:
柔性电子可概括为是将有机/无机材料电子器件制作在柔性/可延性塑料或薄金属基板上的新兴电子技术,以其独特的柔性/延展性以及高效、低成本制造工艺,在信息、能源、医疗等领域具有广泛应用前景,如柔性电子显示器、有机发光二极管OLED、印刷RFID、薄膜太阳能电池板、电子用表面粘贴(SkinPatches)等。与传统IC技术一样,制造工艺和装备也是柔性电子技术发展的主要驱动力。柔性电子制造技术水平指标包括芯片特征尺寸和基板面积大小,其关键是如何在更大幅面的基板上以更低的成本制造出特征尺寸更小的柔性电子器件。 微流控与金属片电极镶嵌工艺,解决流道与电极集成的接触电阻问题并提升检测稳定性。
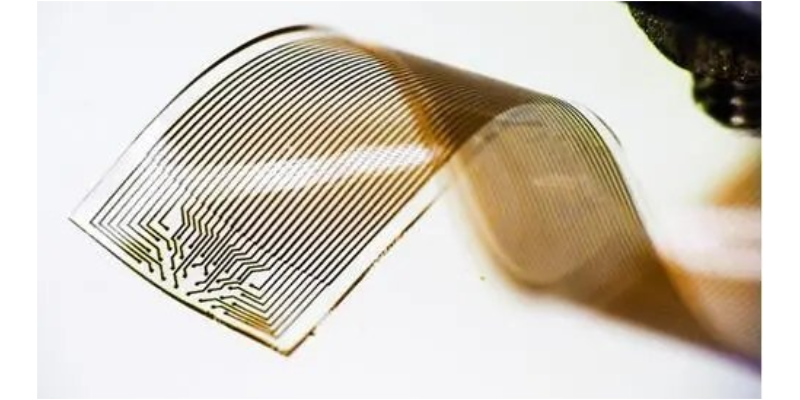
超薄石英玻璃双面套刻加工技术解析:在厚度100μm以上的超薄石英玻璃基板上进行双面套刻加工,是实现高集成度微流控芯片与光学器件的关键技术。公司采用激光微加工与紫外光刻结合工艺,首先通过CO₂激光切割实现玻璃基板的高精度成型(边缘误差<±5μm),然后利用双面光刻对准系统(精度±1μm)进行微结构加工。正面通过干法刻蚀制备5-50μm深度的微流道,背面采用离子束溅射沉积100nm厚度的金属电极层,经光刻剥离形成微米级电极阵列。针对玻璃材质的脆性特点,开发了低温键合技术(150-200℃),使用硅基粘合剂实现双面结构的密封,键合强度>3MPa,耐水压>50kPa。该技术应用于光声成像芯片时,正面微流道实现样本输送,背面电极阵列同步激发光声信号,光-电信号延迟<10ns,成像分辨率达50μm。此外,超薄玻璃的高透光性(>95%@400-1000nm)与化学稳定性,使其成为荧光检测、拉曼光谱分析等**芯片的优先基板,公司已实现4英寸晶圆级批量加工,成品率>90%,为光学微系统集成提供了可靠的制造平台。有哪些较为前沿的MEMS传感器的供应厂家?山东本地MEMS微纳米加工
MEMS常见的产品-声学传感器。个性化MEMS微纳米加工联系人
微纳结构的台阶仪与SEM测量技术:台阶仪与扫描电子显微镜(SEM)是微纳加工中关键的计量手段,确保结构尺寸与表面形貌符合设计要求。台阶仪采用触针式或光学式测量,可精确获取0.1nm-500μm高度范围内的轮廓信息,分辨率达0.1nm,适用于薄膜厚度、刻蚀深度、台阶高度的测量。例如,在深硅刻蚀工艺中,通过台阶仪监测刻蚀深度(精度±1%),确保流道深度均匀性<2%。SEM则用于纳米级结构观测,配备二次电子探测器,可实现5nm分辨率的表面形貌成像,用于微流道侧壁粗糙度(Ra<50nm)、微孔孔径(误差<±5nm)的检测。在PDMS模具复制过程中,SEM检测模具结构的完整性,避免因缺陷导致的芯片流道堵塞。公司建立了标准化测量流程,针对不同材料与结构选择合适的测量方法,如柔性PDMS芯片采用光学台阶仪非接触测量,硬质芯片结合SEM与台阶仪进行三维尺寸分析。通过大数据统计过程控制(SPC),将关键尺寸的CPK值提升至1.67以上,确保加工精度满足需求,为客户提供可追溯的质量保障。个性化MEMS微纳米加工联系人